Nvidia, TSMC, and advanced packaging realignment in 2025
By Majeed Ahmad, EDN (January 20, 2025)
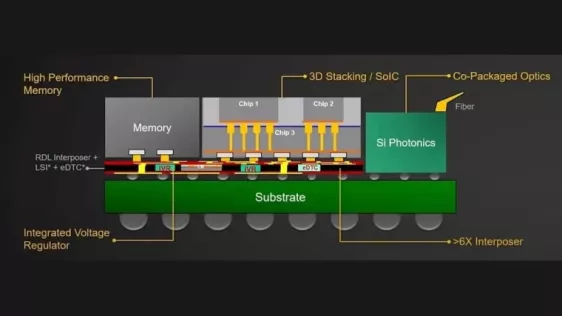
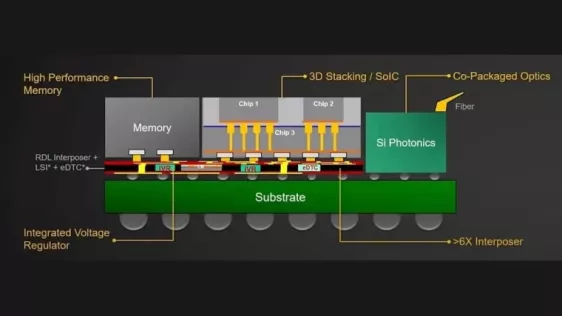 Nvidia’s CEO Jensen Huang has made waves by saying that his company’s most advanced artificial intelligence (AI) chip, Blackwell, will transition from CowoS-S to CoWoS-L advanced packaging technology. That also shows how TSMC’s advanced packaging technology—chip on wafer on substrate (CoWoS)—is evolving to overcome interconnect battles inside large, powerful chips for AI and other high-performance computing (HPC) applications.
Nvidia’s CEO Jensen Huang has made waves by saying that his company’s most advanced artificial intelligence (AI) chip, Blackwell, will transition from CowoS-S to CoWoS-L advanced packaging technology. That also shows how TSMC’s advanced packaging technology—chip on wafer on substrate (CoWoS)—is evolving to overcome interconnect battles inside large, powerful chips for AI and other high-performance computing (HPC) applications.
The CoWoS-S advanced packaging technology uses a single silicon interposer and through-silicon vias (TSVs) to facilitate the direct transmission of high-speed electrical signals between the die and the substrate. However, single silicon interposers often confront yield issues.
To read the full article, click here
Related Chiplet
- DPIQ Tx PICs
- IMDD Tx PICs
- Near-Packaged Optics (NPO) Chiplet Solution
- High Performance Droplet
- Interconnect Chiplet
Related News
- Amkor and TSMC to Expand Partnership and Collaborate on Advanced Packaging in Arizona
- Lorentz Solution Jointly Presents with NVIDIA on Large-Scale 3D Terahertz EM Simulation for Real IC/3DIC Silicon Case Studies in Photonic Switches at 2025 TSMC OIP
- JCET Accelerates Strategic Shift Toward High-End Advanced Packaging, 2025 Advanced Packaging Revenue Hits Record High
- NVIDIA Reportedly Overwhelms TSMC with 3 and 4-Nanometer Orders
Latest News
- AI Optical Interconnect Boom Drives U.S. Firms to Expand Southeast Asia Outsourcing, Opening the Door for Cross-Industry Entrants
- GlobalFoundries accelerates adoption of co-packaged optics for advanced AI data centers with SCALE optical module solution
- TSMC SoIC roadmap targets 2029 chip stacking
- Applied Materials Broadens Advanced Packaging Portfolio with Acquisition of NEXX
- AI Competition Turns into a Supply Chain Arms Race, Tightening Advanced Packaging and 3nm Capacity