Chip Assembler ASE Sees Advanced Packaging Sales Doubling
By Alan Patterson, EE Times | February 16, 2026
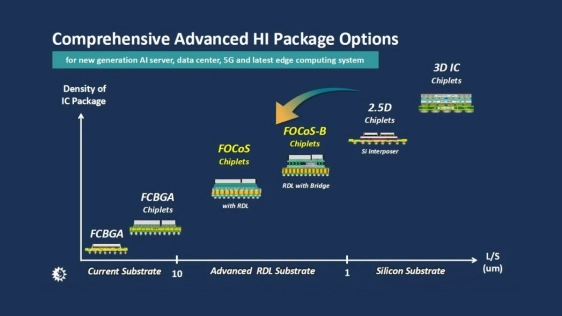
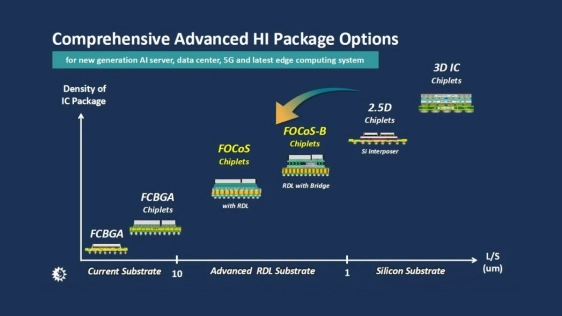 ASE, the world’s largest chip assembler, expects its advanced packaging sales to double this year to $3.2 billion on strong demand from AI chipmakers, such as Nvidia. ASE said it will increase its 2026 capital expenditure by an undisclosed amount from the $5.5 billion it spent last year.
ASE, the world’s largest chip assembler, expects its advanced packaging sales to double this year to $3.2 billion on strong demand from AI chipmakers, such as Nvidia. ASE said it will increase its 2026 capital expenditure by an undisclosed amount from the $5.5 billion it spent last year.
The Taiwanese company is buying cleanrooms and building its own to expand into advanced packaging. Top foundry TSMC is likely to transfer more of the business to ASE as both companies prepare to boost production for AI customers like Nvidia, AMD, and Amazon, according to JPMorgan managing director Gokul Hariharan.
“In 2026, we believe that the primary driver for growth is likely to be on-substrate outsourcing from TSMC for Nvidia GPUs, with a meaningful step up likely in second-half 2026 as [Nvidia] Rubin GPUs start ramping,” Hariharan said in a Feb. 6 report obtained by EE Times. “Full-process packaging should start in second-half 2026, in our view, with AMD Venice CPUs being the first products, and could reach $300 million to $400 million in revenues in 2026, with further room for growth in 2027, as multiple non-GPU products from AMD are moving to ASE’s 2.5D process. In 2027, we also expect to see some [Nvidia] Vera CPU outsourcing coming to ASE, while early discussions indicate potential share gains in [Amazon] Trainium3 ASICs.”
To read the full article, click here
Related Chiplet
- DPIQ Tx PICs
- IMDD Tx PICs
- Near-Packaged Optics (NPO) Chiplet Solution
- High Performance Droplet
- Interconnect Chiplet
Related News
- ISE Labs Investment Secures the Establishment of New Site for Semiconductor Packaging and Test in Mexico
- ASE Expands its Chip Packaging and Testing Facility to Enable Next-Gen Applications
- Biden-Harris Administration Announces Preliminary Terms with Absolics to Support Development of Glass Substrate Technology for Semiconductor Advanced Packaging
- SCHMID Group Takes Next Step Towards Advanced Packaging for Integrated Circuits with Glass Cores
Latest News
- AI Optical Interconnect Boom Drives U.S. Firms to Expand Southeast Asia Outsourcing, Opening the Door for Cross-Industry Entrants
- GlobalFoundries accelerates adoption of co-packaged optics for advanced AI data centers with SCALE optical module solution
- TSMC SoIC roadmap targets 2029 chip stacking
- Applied Materials Broadens Advanced Packaging Portfolio with Acquisition of NEXX
- AI Competition Turns into a Supply Chain Arms Race, Tightening Advanced Packaging and 3nm Capacity